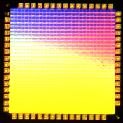
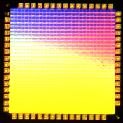
1998 |
|
1997 |
|
1995 |
|
1994 |
|
1993 |
|
Einfluß realistischer Defektformen auf die Größenverteilung von Defekten für die AusbeutevorhersageChristopher Hess, Larg H. WeilandKurzfassung - Modelle zur Ausbeutevorhersage und Berechnungen der "critical area" von hochintegrierten Schaltungen basieren auf kreisförmig modellierten Defekten. Untersuchungen realer Defekte zeigen jedoch zumeist unregelmäßige Defektformen. Daher wird hier der Einfluß realer Defektformen auf die Bestimmung von Defektgrößenverteilungen für die Ausbeutevorhersage untersucht. Um die notwendigen Angaben über Defekte zu erhalten, werden Karree-Teststrukturen eingesetzt, welche eine präzise Lokalisierung von Defekten innerhalb großer Chip-Flächen erlauben. Weiterhin stellen wir ein Verfahren zur Bestimmung einer Defektgrößenverteilung vor, welches die Vielfalt auftretender Defektformen berücksichtigt.GMM-Fachbericht: Vorträge der GME-Fachtagung Mikroelektronik, S. 265-270, München, 1997 Full paper (494k Adobe Acrobat PDF document) |
Verfahren zur optimierten Auswahl, Entwicklung und Datenanalyse von Teststrukturen in Backend-ProzeßschrittenChristopher Hess, Larg H. WeilandKurzfassung - Die zunehmende Komplexität hochintegrierter Schaltungen verlangt mehr und mehr Verdrahtungsebenen, um die einzelnen Schaltungsteile miteinander zu verbinden. Um diese "Backend"-Prozeßschritte zu entwickeln und zu überwachen, sowie um gültige Entwurfsregeln zu erstellen und das Aufkommen von Defekten während der Fertigung zu überprüfen, sind Teststrukturen erforderlich, die hinsichtlich der speziellen Anforderungen vieler übereinander angeordneter Verdrahtungsebenen optimiert sein müssen. Dieser Beitrag stellt zunächst Verfahren vor, um die Anordnung verschiedener Teststrukturen innerhalb von Test-Chips zu optimieren. Um diese Test-Chips zu entwerfen und effizient einzusetzen, wird weiterhin folgendes methodisches Vorgehen vorgeschlagen: Zunächst wird ausgehend von gegebenen Problembeschreibungen eine Test-Chip-Anordnung ausgewählt. Anschließend werden die eigentlichen defektsensitiven Teststrukturen dimensioniert und in diese Test- Chips eingesetzt. Nach der Fertigung folgt die Meßwerterfassung und Datenanalyse zur Defektparameterextraktion.GME-Fachbericht: Vorträge der GME-Fachtagung Mikroelektronik, S. 45-53, Baden-Baden, 1995 Full paper (658k Adobe Acrobat PDF document) |
Modellierung von Defektformen zur rechnergestützen AusbeutevorhersageChristopher Hess, Albrecht P. StroeleKurzfassung - Informationen über Größe, Form und Häufigkeit von herstellungsbedingten Defekten gewinnen immer größere Bedeutung bei der Erstellung von Entwurfsregeln und bei der Ausbeutevorhersage. Die übliche Modellierung mit Kreisen oder Quadraten wird der Vielzahl tatsächlich auftretender Defektformen nicht gerecht. Dieser Beitrag stellt ein verbessertes Modell vor, wobei die Defektform durch eine Ellipse approximiert wird. Die Extraktion der dazu notwendigen Parameter erfolgt mit Hilfe einer neuentwickelten Teststruktur, welche aufgrund ihres regelmäßig strukturierten Aufbaus automatisch generiert und so an die unterschiedlichsten Gegebenheiten angepaßt werden kann.GME-Fachtagung: Rechnergestützter Entwurf und Architektur mikroelektronischer Systeme, S. 218-219, Oberwiesenthal, 1994 Full paper (59k Adobe Acrobat PDF document) |
Teststrukturen zur effizienten produktionsbegleitenden Defektdiagnose und -analyseChristopher HessKurzfassung - Für Defekte, die innerhalb von Verdrahtungsebenen (z. B. Polysilizium-Layer und Aluminium-Layer) auftreten können, wurden Teststrukturen entwickelt, welche diese Defekte innerhalb einer großen Fläche zuverlässig diagnostizieren. Dabei wird die Anschlußpunktkonfiguration üblicher Standard-Chips verwendet sowie die dabei übliche Meßmethode (Digitaltester) eingesetzt. Trotz der dadurch beschränkten Anzahl der Anschlüsse kann durch den Einsatz neu entwickelter Verfahren die gesamte Fläche des Test-Chips in eine große Anzahl wohlunterscheidbarer Karrees unterteilt werden, ohne daß dazu zusätzliche aktive Bauelemente erforderlich sind. Die Anzahl der Karrees wächst dabei quadratisch mit der Anzahl der zur Verfügung stehenden Anschlußpunkte.GME-Fachbericht 11: Vorträge der GME- Fachtagung Mikroelektronik, S. 485-490, Dresden, 1993 Full paper (662k Adobe Acrobat PDF document) |